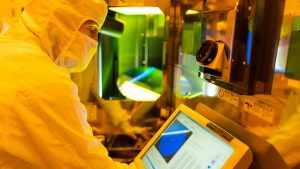
 Наверх
НаверхEUV-литография по-русски: заявлен амбициозный план до 2037 года
Реализуем ли план России по созданию EUV-литографии? Дорожная карта до 2037 года с уникальными технологиями и целями до 10 нм.
Институт физики микроструктур Российской академии наук (через Дмитрия Кузнецова) составил долгосрочную дорожную карту для отечественных инструментов экстремальной ультрафиолетовой (EUV) литографии, работающих на длине волны 11,2 нм, дополнив информацию, которой организация поделилась в декабре прошлого года. Новый проект рассчитан на период с 2026 года, когда будет использоваться 40-нанометровый техпроцесс, до 2037 года, когда будут внедрены техпроцессы менее 10 нм. Последняя дорожная карта выглядит более реалистичной, чем некоторые предыдущие, но ей ещё предстоит доказать свою реализуемость. Кроме того, даже если она будет реализована, её нельзя будет использовать в коммерческих целях.
Первое, что бросается в глаза, — это то, что предлагаемые системы EUV* не повторяют архитектуру инструментов ASML. Вместо этого планируется использовать совершенно другой набор технологий: гибридные твердотельные лазеры, источники света на основе ксеноновой плазмы и зеркала из рутения и бериллия (Ru/Be), которые отражают свет с длиной волны 11,2 нм. Использование ксенона вместо капель олова в инструментах EUV от ASML позволяет избежать образования мусора, который повреждает фотошаблоны, что значительно сокращает необходимость в техническом обслуживании. В то же время, по сравнению с инструментами DUV от ASML, более низкая сложность позволяет избежать использования жидкостей для погружения под высоким давлением и многократного нанесения рисунка для сложных узлов.
Дорожная карта включает три основных этапа.
- Первая система, запуск которой запланирован на 2026–2028 годы, представляет собой литографический станок с разрешением 40 нм, объективом с двумя зеркалами, точностью наложения 10 нм, полем экспозиции до 3 x 3 мм и производительностью более пяти пластин в час.
- На втором этапе (2029–2032 гг.) будет представлен сканер с длиной волны 28 нм (с возможностью использования длины волны 14 нм), в котором используется четырёхзеркальная оптическая система. Он обеспечивает точность наложения 5 нм, поле экспозиции 26 x 0,5 мм и производительность более 50 пластин в час.
- Последняя система (2033–2036 гг.) предназначена для производства на глубине менее 10 нм с использованием конфигурации из шести зеркал, выравнивания наложения с точностью до 2 нм и размеров полей до 26 x 2 мм. Она рассчитана на производительность более 100 пластин в час.
Ожидается, что с точки зрения разрешения эти инструменты будут поддерживать диапазон от 65 до 9 нм, что соответствует требованиям для многих критически важных слоёв, которые будут использоваться в 2025–2027 годах. Каждое поколение повышает оптическую точность и эффективность сканирования, сохраняя при этом значительно более низкую стоимость единицы продукции по сравнению с платформами Twinscan NXE и EXE от ASML.
Примечательно, что разработчики заявляют о нескольких неожиданных преимуществах использования EUV-литографии для замыкающих узлов. Однако они ни разу не упомянули о сложностях, связанных с использованием лазера с длиной волны 11,2 нм (разные зеркала, разные инструменты для полировки зеркал, разная оптика, разные источники света, разные блоки питания, резист и т. д.), которая не является стандартной для EUV-литографии. Нажмите на твит ниже, чтобы развернуть дорожную карту.
В целом эта дорожная карта может отражать план России по достижению независимости в производстве микросхем за счёт обхода традиционных ограничений EUV. Однако неясно, насколько реализуем этот план, поскольку он предполагает скачкообразный переход всей отрасли на новый уровень, что ещё предстоит доказать.
Вместо того чтобы стремиться к максимальной производительности для гипермасштабных фабрик, эти инструменты нацелены на экономически эффективное внедрение в небольших литейных цехах. Предлагая чистую, эффективную и масштабируемую систему литографии, не требующую иммерсионной обработки или плазмы на основе олова, российская платформа может заинтересовать международных клиентов, которые в настоящее время не входят в экосистему ASML. В случае полной реализации проект может обеспечить передовое производство микросхем как для внутреннего, так и для экспортного рынка при значительно меньших капитальных и операционных затратах.
*Системы EUV когда-то назывались «мягким рентгеновским излучением», отсюда и слайд на русском языке с упоминанием «рентгеновской» литографии.
GAC и Huawei объединились, чтобы создать новый премиальный бренд электромобилей Qijing









